EUV 반도체 포토레지스트, ‘질산염 음이온’ 도입으로 감도와 안정성 동시 향상
국내 연구진이 주석 옥소 클러스터 기반의 신형 EUV 포토레지스트에 광활성 질산염 음이온을 도입하여, 반도체 제조에 중요한 감도와 안정성을 동시에 혁신적으로 개선하였다.
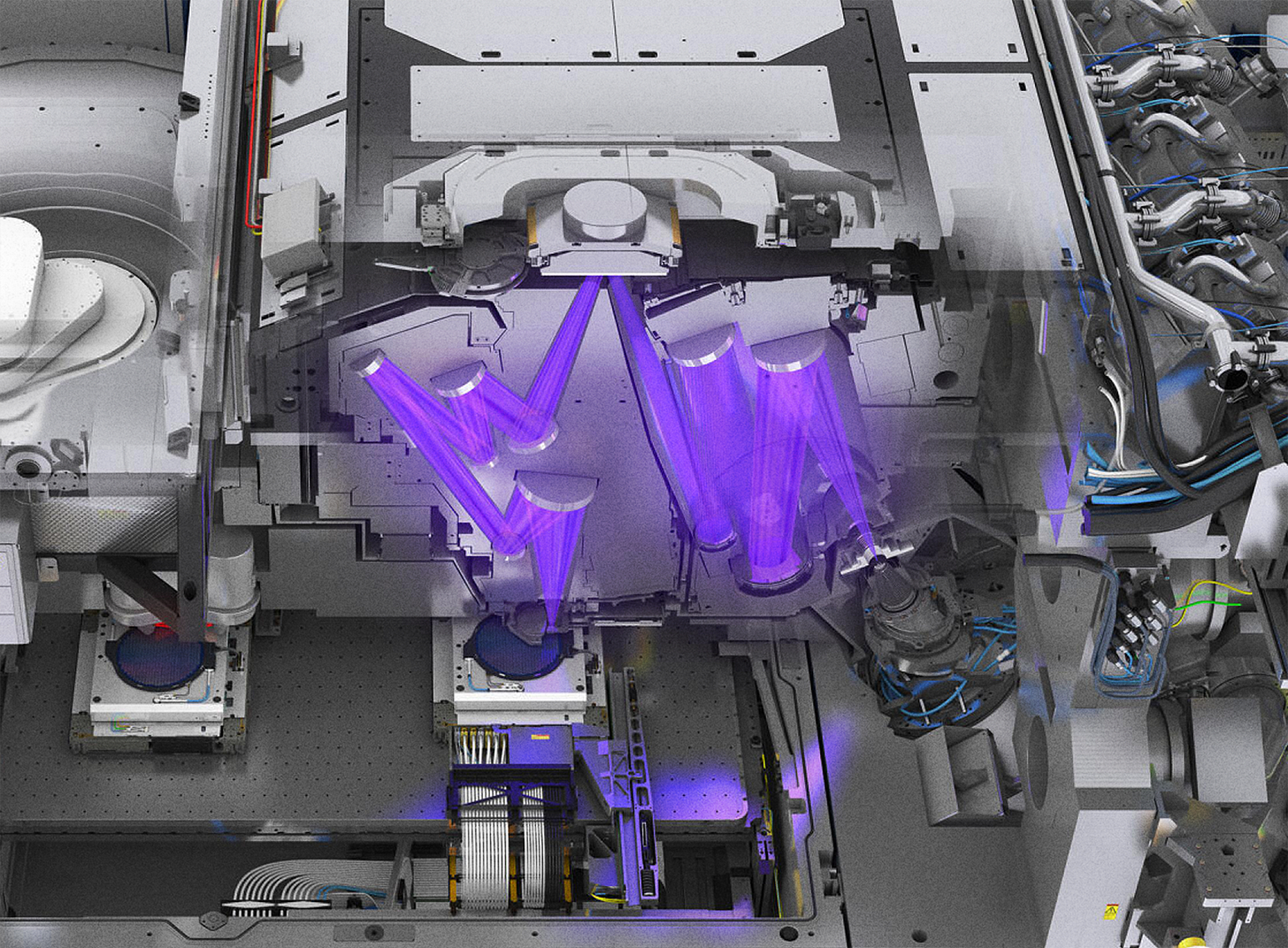
극자외선(EUV) 리소그래피는 13.5 nm 파장의 빛을 이용해 반도체 칩에 나노미터 수준의 미세 패턴을 새기는 차세대 핵심 기술입니다. 이 기술은 92 eV라는 매우 높은 광자 에너지를 활용하여 기존 기술로는 불가능했던 초미세 회로 패턴을 구현할 수 있습니다. 하지만 기존에 사용되던 유기 화학증폭형 포토레지스트(CAR)는 여러 한계에 직면해 있습니다. 산 촉매가 무작위로 확산되면서 패턴 가장자리가 거칠어지는 현상이 발생하고, EUV 광을 충분히 흡수하지 못해 효율이 떨어지며, 여러 성분이 섞인 복잡한 구조 때문에 균일한 박막을 만들기 어렵다는 문제가 있었습니다.
이러한 문제를 해결하기 위해 최근 무기 금속 기반 포토레지스트, 특히 주석(Sn) 옥소 클러스터가 유망한 대안으로 떠오르고 있습니다. 주석은 92 eV 영역에서 매우 큰 광흡수 단면적을 가지고 있어, 겨우 25 nm 두께의 얇은 막으로도 EUV 광자의 약 25%를 흡수할 수 있습니다. 이는 유기 포토레지스트보다 월등히 높은 수치로, 더 얇은 막으로도 효과적인 패터닝이 가능하다는 것을 의미합니다. 또한 주석 클러스터는 분자 크기가 작아 해상도가 높고, 단일 성분 구조로 균일한 박막 형성이 용이하다는 장점도 있습니다.
연구 목적

주석 옥소 클러스터 기반 EUV 포토레지스트는 높은 잠재력에도 불구하고 감도(photosensitivity)와 안정성(stability) 사이에 상충 관계가 존재한다는 근본적인 문제를 안고 있습니다. 감도가 높은 포토레지스트는 적은 양의 빛으로도 빠르게 반응하여 생산성을 높일 수 있지만, 반대로 장기 보관 시 자연적으로 분해되거나 변질될 위험이 큽니다. 반면 안정성이 높은 포토레지스트는 오랫동안 품질이 유지되지만, 반응하는 데 많은 양의 빛이 필요해 제조 공정이 느려지고 비용이 증가합니다.
이 연구는 이러한 감도-안정성의 딜레마를 해결하기 위해 광활성 질산염 음이온(photoactive nitrate anion)을 주석 클러스터에 통합한 새로운 소재 (BuSn)₁₂O₁₄(OH)₆₂ (TinNO₃)를 개발하는 것을 목표로 했습니다. 연구팀은 질산염 음이온이 단순히 구조적 역할만 하는 것이 아니라, EUV 빛을 받았을 때 직접 화학 반응에 참여하여 감도를 높이면서도 안정성을 유지할 수 있을 것이라는 가설을 세웠습니다. 이를 통해 실제 반도체 제조 공정에 적용 가능한 고성능 포토레지스트를 개발하고자 했습니다.
핵심 혁신: 광활성 질산염 음이온의 역할
기존의 주석 클러스터 기반 포토레지스트들은 각기 다른 음이온을 사용했지만, 모두 일장일단이 있었습니다. TinOH는 수산화 음이온을 가지고 있어 37 mJ/cm²이라는 높은 감도를 보였지만, 음이온이 주석 클러스터로부터 양성자를 빼앗는 탈양성자화 반응을 일으켜 장기 보관 시 구조가 불안정해지는 문제가 있었습니다. 반면 TinTos는 토실레이트 음이온을 사용하여 안정성은 확보했지만, 104 mJ/cm²라는 낮은 감도로 인해 제조 속도가 느리고 비용이 많이 드는 단점이 있었습니다. TinCl 역시 안정적이지만 감도가 낮아 같은 문제를 겪었습니다.
기존 연구자들은 음이온의 역할을 단순히 전하 균형을 맞추고 클러스터끼리 뭉치지 않도록 간격을 유지하는 비반응성 스페이서 정도로 여겼습니다. 하지만 본 연구팀은 질산염 음이온이 EUV 조사 시 광반응에 직접 참여한다는 획기적인 발견을 했습니다. EUV 빛을 받으면 주석-탄소(Sn-C) 결합이 끊어지며 라디칼 중간체가 생성되는 기존 메커니즘에 더해, 질산염 음이온이 추가적인 라디칼 종을 생성한다는 것입니다. 이렇게 생성된 추가 라디칼들은 인접한 클러스터와 가교 반응을 일으켜 불용성 네트워크를 더 빠르게 형성합니다.
X선 광전자 분광법(XPS) 분석 결과, EUV 조사 후 TinNO₃의 탄소 대 주석 비율(C1s/Sn3d)이 0.2에서 0.03으로 급격히 감소했습니다. 이는 TinTos의 경우(0.2에서 0.1로 감소)보다 훨씬 큰 변화로, 질산염 음이온이 실제로 추가적인 화학 반응에 참여하고 있음을 입증합니다. 또한 Sn 4d 코어 레벨과 가전자대(valence band) 분석에서도 광이온화 현상이 확인되어, 질산염 음이온이 광활성을 가지고 있다는 것이 과학적으로 증명되었습니다. 이러한 메커니즘을 통해 TinNO₃는 높은 감도를 유지하면서도 구조적 안정성을 잃지 않는 독특한 특성을 갖게 되었습니다.
주요 연구 결과
TinNO₃는 32 mJ/cm²의 감도를 달성하여 기존의 TinTos(104 mJ/cm²)보다 3배 이상 향상된 성능을 보였습니다. 이는 동일한 패턴을 형성하는 데 필요한 EUV 노광량이 3분의 1로 줄어든다는 것을 의미하며, 반도체 제조 공정에서 생산 속도(throughput)를 획기적으로 높일 수 있다는 점에서 매우 중요합니다. 32 mJ/cm²라는 수치는 최신 화학증폭형 유기 포토레지스트와 비교해도 우수한 수준으로, 상용화 가능성을 보여줍니다.
안정성 측면에서도 TinNO₃는 뛰어난 성능을 입증했습니다. 노광 후 베이크(Post-Exposure Bake, PEB) 과정에서 온도나 시간 조건이 달라져도 현상액에 대한 용해도가 일정하게 유지되었습니다. 이는 공정 변수에 민감하지 않아 대량 생산 시 수율을 안정적으로 확보할 수 있다는 것을 의미합니다. 또한 대기 중에 장기간 보관해도 화학적 구조와 성능이 변하지 않아, 물류 및 재고 관리가 용이하다는 실용적 장점도 있습니다. 기존에는 감도와 안정성 중 하나를 선택해야 했다면, TinNO₃는 이 두 가지를 동시에 달성한 첫 사례입니다.
건식 식각 내구성 실험에서는 TinNO₃가 실리콘(Si) 기판과 비정질 탄소층(amorphous carbon layer)에 대해 높은 선택비를 가지고 있음이 확인되었습니다. 이는 패턴 전사 공정에서 포토레지스트가 식각 마스크로 사용될 때, 아래층은 제거되면서도 레지스트 패턴 자체는 온전히 유지된다는 것을 뜻합니다. 반도체 제조 공정은 여러 단계의 식각과 증착을 거치기 때문에, 이러한 내구성은 실제 양산 적용을 위한 필수 조건입니다.
ArF 리소그래피(193 nm 파장)를 이용한 실험에서는 CD(Critical Dimension) 45 nm의 라인/스페이스(L/S) 패턴을 성공적으로 구현했습니다. 연구팀은 PEB 온도와 시간, 포토레지스트와 기판 사이의 접착력, 현상 조건 등을 정밀하게 최적화하여 선명하고 균일한 패턴을 얻었습니다. 전계방출 주사전자현미경(FE-SEM)으로 촬영한 이미지에서 패턴의 라인 엣지 거칠기(LER)가 낮고 패턴 충실도가 높은 것으로 나타나, 실제 반도체 소자 제조에 적용할 수 있는 수준의 품질임이 입증되었습니다. 이는 연구실 단계의 개념 증명을 넘어 실용화 가능성을 보여준 중요한 성과입니다.
다음 포스트에서 내용이 이어집니다.




